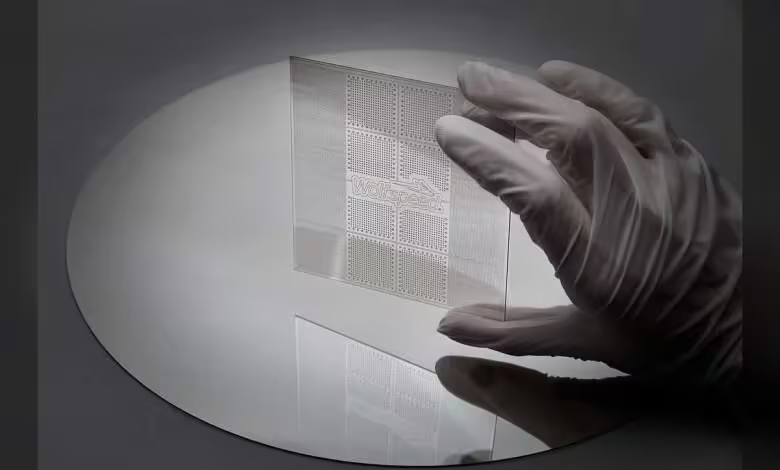
Les charges AI gonflent les boîtiers et la dissipation grimpe ; Wolfspeed pousse le carbure de silicium en 300 mm pour suivre le rythme. Objectif : en faire un socle matériel pour l’emballage hétérogène AI/HPC d’ici la fin de la décennie.
Silicon carbide 300 mm : alignement sur l’infrastructure 300 mm
Wolfspeed, Inc. (NYSE : WOLF) positionne sa plateforme 300 mm en carbure de silicium (SiC) comme matériau clé pour contourner les limites thermiques, mécaniques et électriques de l’emballage AI/HPC. L’entreprise a validé en janvier 2026 la production d’un wafer SiC monocristallin au format 300 mm, point d’ancrage pour des interposeurs et dissipateurs plus grands, compatibles avec les outils de fabrication et de packaging en salle blanche 300 mm.
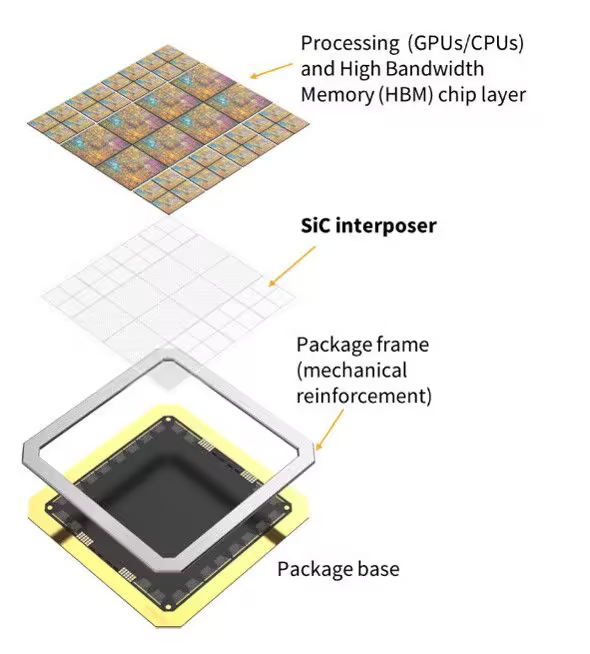
Le SiC combine haute conductivité thermique, robustesse mécanique et propriétés électriques favorables. À l’échelle 300 mm, il s’insère dans les flux de fabrication avancés, avec un potentiel de répétabilité et de volumes industriels, tout en conservant la compatibilité écosystème (fonderies, OSAT, packaging wafer‑level).
Elif Balkas, CTO de Wolfspeed, souligne l’explosion de la taille des packages, de la densité de puissance et de la complexité d’intégration sous l’effet des workloads AI. L’objectif est d’étendre la feuille de route packaging en apportant une base matérielle plus adaptée aux architectures hétérogènes de nouvelle génération.
Partenariats et trajectoire d’adoption
Wolfspeed conduit un programme d’évaluation avec des fonderies, OSAT, architectes systèmes et instituts de recherche. Les travaux portent sur la faisabilité technique, les gains de performance, la fiabilité et les voies d’intégration vers des architectures hybrides SiC‑silicium adaptées aux futurs besoins AI.

Le format 300 mm facilite la montée en surface des interposeurs et la réalisation de heat spreaders plus larges, mieux dimensionnés pour des assemblies multi‑composants de plus en plus vastes. À terme, l’alignement avec l’infrastructure 300 mm doit aider à sécuriser la fabrication en volume et les trajectoires de coûts.
Implication pour les data centers AI
Si le SiC 300 mm prouve ses gains thermiques et mécaniques en interposer/heat spreader, il peut desserrer la contrainte de densité de puissance des packages AI/HPC tout en restant dans les chaînes 300 mm existantes. L’enjeu sera la qualification fiabilité et le coût matière face aux solutions à base de silicium et composites, avec un intérêt évident pour les designs HPC massifs de fin de décennie.
Source : TechPowerUp

